2025年03月07日 08:52:34 来源:上海艾时微技术开发有限公司 >> 进入该公司展台 阅读量:5
半导体工业自上世纪40-50年代诞生至今,已经历了70余年的发展,从最初的宏观电子管、晶体管发展到如今的 7-10nm,甚至 5nm工艺节点,芯片结构也由单层结构发展到如今的十余层结构。其突飞猛进的发展离不开光刻、镀膜、刻蚀工艺的进步。而各工艺的进步,特征尺寸得不断减小,必然伴随着设备、工艺、材料和检测技术的配套发展。

Vista-IR红外光诱导力显微镜可以实现10 nm以下空间分辨的可见-红外化学成像与光谱采集,从而获得材料在纳米尺度下的分布与组成。其产品已获得诸多半导体上下游企业的青睐,成功应用在光刻胶层中的纳米化学组分分析、制程中纳米级缺陷与污染物的成分分析、原子层工艺表征等领域。
EUV光刻胶不同曝光剂量的研究
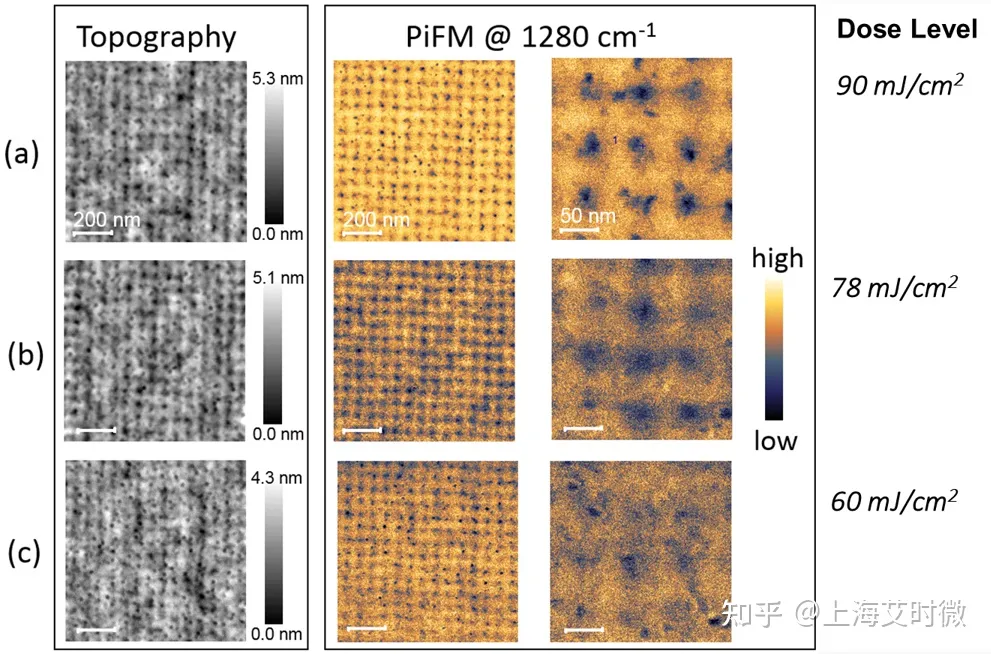
单纯通过AFM形貌变化来比较剂量的曝光效果是非常困难的,PiFM不受形貌的影响,可以清楚地表明60mJ/cm2的剂量是不够的,进而来进一步分析合适的曝光剂量。
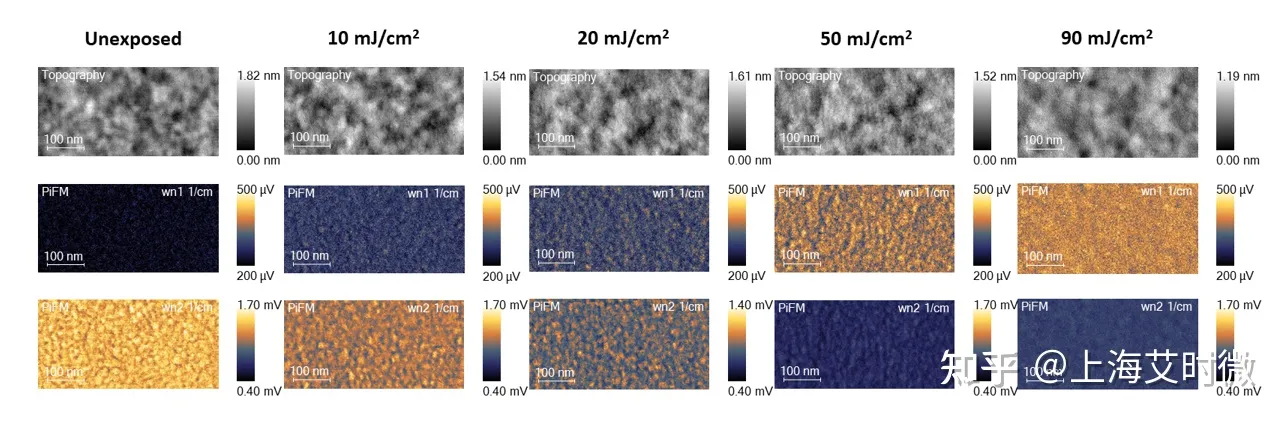
PiFM-IR可以检测电子束和EUV胶曝光前后相对应的化学变化。对于具有明显lR特征的光刻胶,基于化学变化的图像要比基于形貌变化的图像敏感得多。在金属氧化物EUV光刻胶上观察到了化学特征随剂量变化的趋势,并将在图案化样品中进一步研究。
化学放大EUV胶曝光分析
在t-BOC光刻胶的EUV曝光中,曝光和未曝光的掩模区域之间会出现形貌差异。PiFM结果表明形貌变化与红外活动相关,曝光前后峰位置偏移了6cm-1。1280 cm−1处的强信号可以用来识别未曝光区域,而1514 cm−1峰为曝光区域。

对于45 nm特征尺寸曝光样品,PiFM提供了结果更明确的图像(与AFM形貌相比)。由于光刻胶曝光严重不足,仅导致聚合物发生微小变化。由45 nm特征在形貌中无法分辨,但通过1760cm-1处特征峰信号的降低,PiFM能够从这些特征中检测到微小的化学变化。
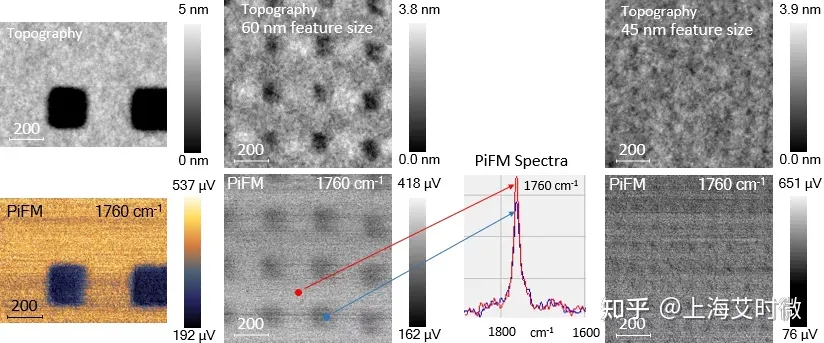
半导体纳米线器件应变研究
通过硅中的局部应变增强载流子迁移率是改善晶体管性能的一种手段。为了有效地验证器件设计和工艺条件,需要直接测量纳米级的应变。用PiFM对FinFET中SiGe沟道进行了应变表征,结果显示应变在SiGe线处,并且在远离SiGe线的地方松弛。表明PiFM可以真正的实现纳米级应变测量。

SiC layer结晶度研究
利用红外光诱导力显微镜(IR PiFM)对于退火前后的SiC layer的结晶度进行光谱采集与成像,有别于拉曼光谱(Raman)微米级的空间分辨率,IR PiFM的空间分辨率可达10 nm以下,并且也是无损检测。922 cm-1为SiC晶体的声子振动频率,可以用作为判断结晶度的特征峰。PiFM结果显示EB+1700°C后的SiC layer有着比4H-SiC基底更高的结晶度,此结果与Raman光谱表征结果相匹配。

半导体纳米污染物及残留物研究
制造过程中缺陷与污染物的管理至关重要,了解缺陷与污染物的来源,化学成分是一个关键要素,它能为减少和去除缺陷与污染物提供依据。图a形貌图显示缺陷的大小约为100 nm,厚度约为3 nm。1090 cm-1附近属于SiO2的特征峰,缺陷上的PiF-IR光谱与Teflon的FTIR光谱很好地匹配,使我们能够将该缺陷识别为Teflon。图b中的形貌图显示缺陷的大小约为50 nm,厚度约为15 nm。片与缺陷颗粒上的多条PiF-IR光谱显示出很高的重复性。1060 cm-1为中心的宽峰属于Si的特征峰,缺陷颗粒上的PiF-IR光谱与SiO2的FTIR光谱很好地匹配,使我们能够将该缺陷识别为SiO2。这两个案例表明PiFM可以很好地识别纳米级有机与无机材料的化学成分。

有机自组装层ALD选择性沉积
有机自组装单层(SAM)充当掩模以促进或抑制选定区域中的原子层沉积。在下面的案例中,SAM选择性地抑制金属区域沉积,并允许氧化铝优先沉积在暴露的氧化物区域上。SiO2、SAM 和 Al2O3 分别对应1103cm-1、1471cm-1和 972 cm-1 处的成像。尽管SAM和氧化铝不是局部的,在较低和较高浓度的区域仍然可以看到对比。
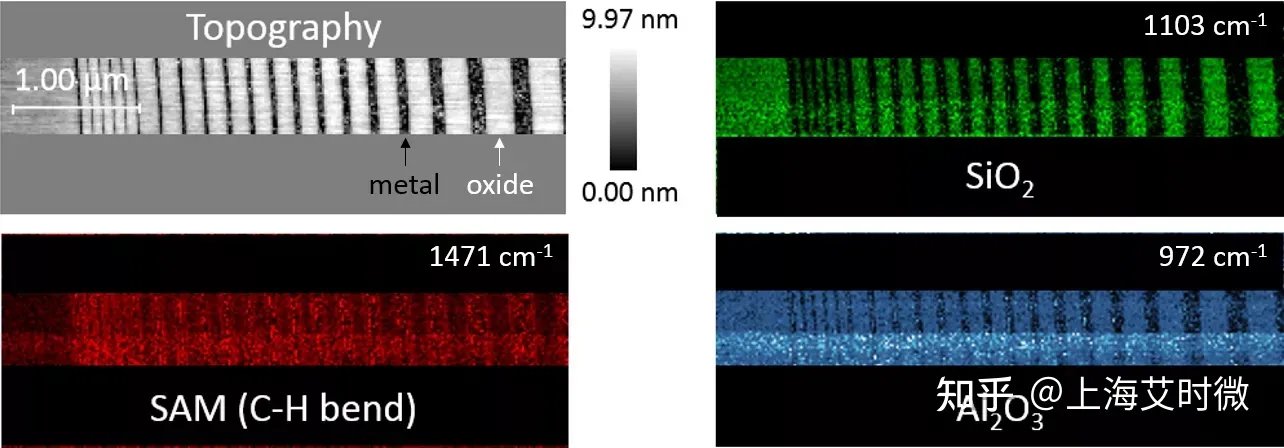
沟槽横截面纳米红外成像分析
半导体器件中的沟槽由Vista-IR进行横截面和成像。根据每种材料的红外吸收突出显示两种不同的材料。在两种材料的界面上以10nm间距采集光谱,,通过观察1100 cm−1处的峰的过渡,表明从一种材料到另一种材料的转变发生在光谱18到20之间。PiFM可以以低于10 nm的空间分辨率提供局部化学信息。

CMP样品介电常数分析
经过化学机械抛光(CMP)的样品通过PiFM成像可以区分不同区域。虽然金属不是红外活性的,但它们可以通过不同波长的介电常数来识别。在下图中,PiFM结果区分了金属,阻挡层金属和氧化物区域。

总结
纳米红外光诱导力显微镜(Molecular Vista纳米红外):可以实现10 nm以下空间分辨的光谱采集与红外化学成像,在半导体中可以用来:
1.进行DUV/EUV等光刻胶材料的分析,研究曝光前后的化学变化;
2.纳米级缺陷与污染物的成分分析,研究纳米级缺陷成分;
3.纳米尺寸器件的应变研究;
4.衬底材料结晶度分析;
5.MOSFET沟槽横截面成像分析;
6.有机自组装层ALD选择性沉积研究;
7.介电常数分析等。
参考文献
PiFM study of latent EUV in t-BOC chemically amplified resist in collaboration with G. Wallraff, M. Sanchez, H. Truong – IBM Almaden
SiC structural characterization by non destructive near-field microscopy techniques,2022 International Semiconductor Conference (CAS)
Vista One Platform:
Visible ~ IR chemical imaging and spectroscopy, E-field imaging, photovoltage/current imaging with sub-10 nm spatial resolution. Also being combined with Confocal Raman, PL imaging and other kinds of far field spectroscopy and optical microscopy.

Molecular Vista Inc.,Vista IR