2025年03月07日 08:56:37 来源:上海艾时微技术开发有限公司 >> 进入该公司展台 阅读量:5
缺陷与污染物:
缺陷与污染物伴随着制造过程永远存在,对于产品的稳定性、可靠性与良品率有直接的影响。缺陷与污染物可能是将制造扼杀在摇篮里的首要原因之一,制程增长的能力则依赖于缺陷与污染物问题的解决。因此,制造过程中缺陷与污染物的管理至关重要。缺陷与污染物可能源于制造过程中引入了不需要的异物、材料去除不所余下的残留物、材料与化学剂所引起的意外反应,或由外部环境中如热、湿气与光所引起的缓慢化学反应等。为了能够了解缺陷与污染物的来源,化学成分是一个关键要素,它能为减少和去除缺陷与污染物提供依据。
缺陷与污染物的常规分析方法:
大多数分析实验室都配备了元素的分析技术,例如能量色散X射线光谱(EDX)、全反射X射线荧光光谱(TXRF)和具有纳米空间分辨的俄歇电子能谱(AES)。虽然这些技术在识别金属和一些无机材料方面很有用,但对于具有相同元素组成的有机或无机材料方面则用处有限,因为它们不揭示任何化学键信息。对于分子信息的识别,傅里叶红外光谱(FTIR)是使用泛的技术,但其空间分辨率仅为10 μm。虽然其他技术例如拉曼光谱(Raman)、飞行时间二次离子质谱(TOF-SIMS)和X射线光电子能谱(XPS)可以识别更小的尺度,但它们所标称的空间分辨率为200 nm,且也存在检出限。鉴于上述这些缺陷与污染物分析技术,当缺陷与污染物的横向尺寸小于约1 μm时,通常需要组合使用这些分析技术,从而“推测”缺陷与污染物的分子信息。当缺陷与污染物的厚度小于100 nm时,分析难度会更大,因为其中一些技术在分析超薄厚度的样品时,信噪比较低。
光诱导力显微镜:
Photo-inducedForce Microscope, PiFM可以实现10 nm以下空间分辨的光谱采集与红外化学成像,非常适合用来分析制程中纳米级缺陷与污染物的成分。相较于上述分析技术,PiFM可以采集10 nm区域内的光诱导力(PiF-IR)光谱,其与FTIR光谱非常匹配,可以根据完善的FTIR光谱数据库来确定缺陷与污染物的成分。其大致原理为一束脉冲激光激发至样品和针尖,样品吸收特定波长的激发光后与针尖形成偶极与偶极(电子云与电子云)的交互即样品吸收特定红外波长后所产生的偶极矩变化。探针悬臂通过振幅或频率调制可以获得表面形貌图、PiFM光诱导力图/红外化学成像(缺陷分布)、光谱采集(缺陷组成)。

光诱导力显微镜测量纳米级缺陷与污染物的优势:
对于缺陷的尺寸和化学成分进行测量与分类。
光诱导力显微镜分析纳米颗粒缺陷:
图1为20 nm的PS纳米颗粒与云母衬底上采集的PiF-IR光谱(红、蓝)和云母与PS两者的FTIR光谱(黄、绿)对比。三幅图像分别为形貌、1492 cm-1与1025 cm-1下的PiFM成像,分别用于显示PS纳米颗粒与云母衬底的分布。PiF-IR光谱结果还显示出了1100至1360cm-1之间FTIR所没有显示的特征峰。可能是由于液体中的分子(例如表面活性剂)与PS纳米颗粒一起沉积在云母衬底上。

图1. 20 nm的PS纳米颗粒与衬底云母上采集的PiF-IR光谱(红、蓝)和云母与PS两者的FTIR光谱(黄、绿)对比;图像分别为形貌、1492与1025 cm-1下的PiF-IR成像。
图2为PiF-IR光谱在硅片上发现未知缺陷的两个案例。图2a中的形貌图显示缺陷的大小约为100 nm,厚度约为3 nm。硅片上的PiF-IR光谱清楚地显示了1090 cm-1附近属于二氧化硅的特征峰。缺陷上的PiF-IR光谱与Teflon的FTIR光谱很好地匹配,使我们能够将该缺陷识别为Teflon。图2b中的形貌图显示缺陷的大小约为50 nm,厚度约为15 nm。考虑针尖曲率半径的展宽,缺陷可以被视为是一个直径约为15 nm的球形颗粒。硅片与缺陷颗粒上的多条PiF-IR光谱显示出很高的重复性。1060 cm-1为中心的宽峰属于硅片的特征峰,缺陷颗粒上的PiF-IR光谱与二氧化硅的FTIR光谱很好地匹配,使我们能够将该缺陷识别为二氧化硅。这两个案例表明PiFM可以很好地识别纳米级有机与无机材料的化学成分。

图2. 缺陷与硅片上采集的PiF-IR光谱(蓝、紫)和Teflon红外光谱对比(黄) (a); 缺陷与硅片上采集的PiF-IR光谱和二氧化硅红外光谱对比(黄) (b)。
光诱导力显微镜分析残留物:
另一种常见的缺陷形式是残留物。当残留物的厚度很薄时,常规的光学显微镜或光谱仪很难检测到它们的存在。图3是焊盘上未知残留物的分析案例,该焊盘未正确粘附到其连结部件上。PiF-IR光谱揭示了清晰的化学特征,指向加工过程中副产品产生的残留物。图3a为焊盘的形貌,图3b为与残留物特征吸收下的PiFM成像。PiFM信号强度与残留物吸收强度有关。在图3b中,黄色区域为存在残留物的地方。残留物的厚度最多为几个纳米,因为形貌图并没有显示出焊盘上与残留物相关的特征,而显示了焊盘上所使用的金属颗粒状结构。在这个分析案例中,金属焊盘的化学性质或残留物没有被特意。
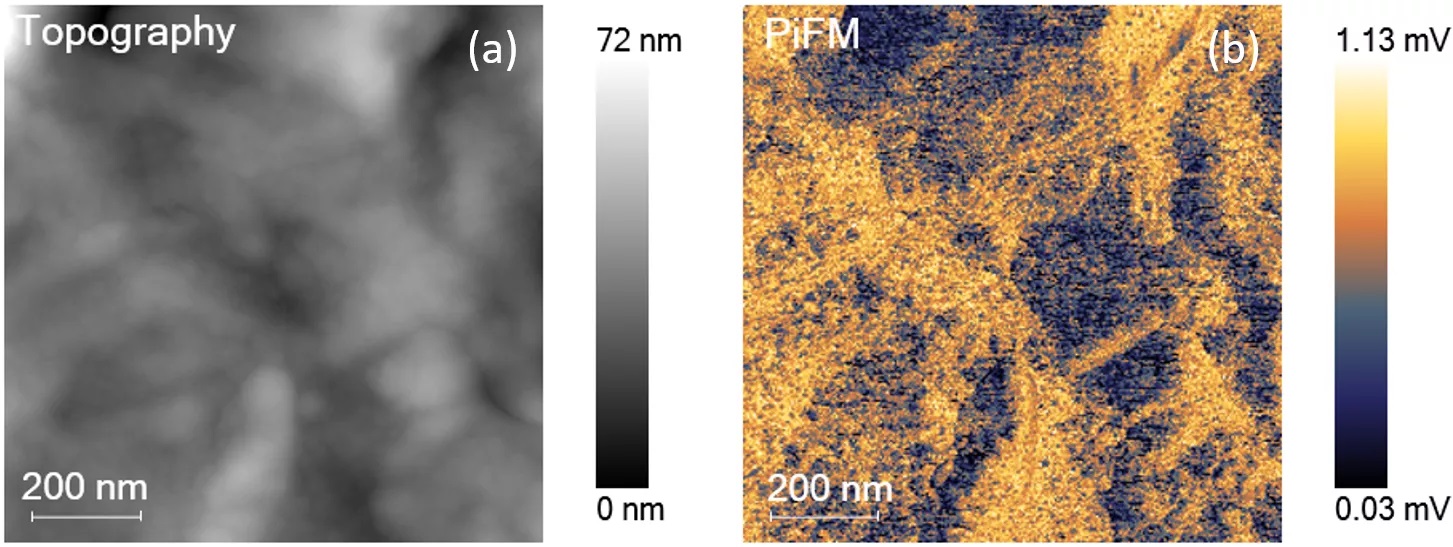
图3. 金属焊盘的形貌图(a) 与光诱导力图 (b) ;利用残留物的红外特征吸收,光诱导力显微镜显示了残留物的分布(黄色区域)。
结论:
样品分析案例很好的说明了光诱导力显微镜对于纳米级未知缺陷与污染物的分析能力,可以识别超薄且横向尺寸为10 nm有机与无机材料的化学成分。当缺陷与污染物的尺寸与厚度超出当前的分析技术例如图4中Raman、FTIR、TOF-SIMS、XPS和SEM/EDS的检测能力时,光诱导力显微镜可以作为重要补充以了解缺陷与污染物的化学成分。
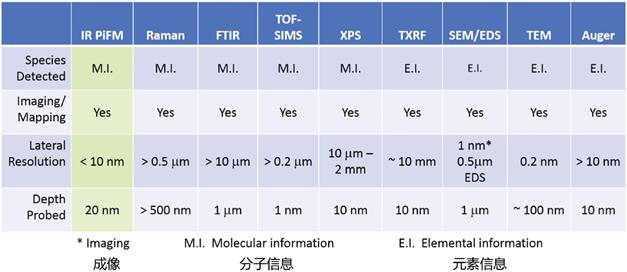
Vista OnePlatform:
Visible~ IR chemical imaging and spectroscopy, E-field imaging, photovoltage/currentimaging with sub-10 nm spatial resolution.
Alsobeing combined with Confocal Raman, PL imaging and other kinds of far fieldspectroscopy and optical microscopy.
